在半导体封装领域,铜-金(Cu-Au)引线键合系统因其成本优势与良好的冶金相容性,正逐步替代传统金-金系统。然而,异种金属界面长期可靠性仍是亟待解决的行业痛点。本文科准测控小编将从力学检测视角,为您系统阐述Cu-Au键合界面失效机理与定量评估方法。
一、失效根源:Kirkendall空洞
根据Cu-Au二元相图,该体系会形成Cu₃Au、AuCu和Au₃Cu三种韧性金属间化合物,其形成活化能为0.8~1.0 eV。可靠性问题的核心在于异种金属扩散速率差异所引发的Kirkendall空洞效应,具体表现为Cu原子向Au侧扩散速率显著高于Au原子向Cu侧扩散速率,导致Cu侧出现空位聚集,并逐渐发展为微观空洞。空洞的形成直接减少键合界面的实际承载面积。

Cu-Au二元相图
二、强度衰减的定量模型
相关文献对引线框架上的热压键合进行了系统的温度-时间研究。通过定期测试键合强度,建立了强度衰减与老化条件之间的定量关系:
活化能一致性:强度衰减速率符合Arrhenius动力学,表观活化能与Cu-Au扩散活化能吻合,证实空洞扩散是主导机制;
失效判据与寿命:以键合强度降低40%为失效判据,预测100℃持续工作条件下寿命约为5年。若判据放宽至50%或60%,预期寿命相应延长;
气氛影响:真空中老化的试样强度保持率显著高于空气中老化的试样,表明氧化环境加速界面损伤。
下图给出了键合强度降低至初始值40%时,温度与达到失效时间的关系曲线,该拟合结果为工程寿命预测提供了直接依据。
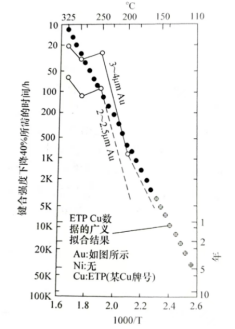
三、工艺因素影响
从力学检测角度来看,Cu-Au键合强度受以下工艺参数影响较为显著,不过鉴于Cu表面清洁工艺较为复杂,业界普遍采用连续点镀Ag或薄Pd膜层作为工程优化方案。
工艺参数 | 影响 |
Cu层微观结构与纯度 | 细晶组织可能加速空洞形成,杂质元素作为空洞优先形核点 |
表面清洁度 | Cu表面氧化层阻碍金属原子直接接触,导致有效键合面积减小 |
气氛控制 | 需使用中性或还原气氛防止氧化,但成本相应增加 |
空洞无法在线监测,但其累积效应可通过力学测试精确表征,比如,可以通过键合强度测试来量化空洞导致的承载面积损失,通过断口分析可以确定失效是否由空洞导致。通过多温度点老化-测试组合,可拟合活化能参数,建立从工艺条件到服役寿命的量化映射。

科准测控自主研发的Alpha W260系列微电子推拉力试验机,专为半导体封装检测设计:0.5级精度准确捕捉微米级键合点强度变化;支持剪切、拉力、疲劳等多种测试模式;配套软件自动拟合强度衰减曲线,直接输出寿命预测参数;可集成环境箱满足多场耦合测试需求。从微观空洞到宏观数据,我们致力于为您提供可量化的力学检测解决方案。如您对铜金键合体系有更多疑问,或对可靠性分析,推拉力试验机产品等有任何想要了解的内容,请联系我,工程师将竭诚为您服务。