作为半导体封装质量监控的重要环节,金球推力测试对保障储存芯片的可靠性和寿命至关重要。金球推力测试是一种用于测量焊接球与基板之间剪切强度的测试方法,能够有效评估焊接点的质量和可靠性。

在储存芯片的封装过程中,金线键合是将芯片与外部电路连接的主要技术,其质量直接影响到整个芯片的性能和寿命。科准测控小编将详细介绍金球推力测试的原理、标准及操作流程,帮助您全面理解这一关键的测试方法。
一、测试原理
金球推力测试是通过机械应力模拟来评估半导体封装中焊点连接可靠性的关键技术。该测试采用水平推力评估球焊点与基板间的结合质量。

测试时,推刀以水平方向对焊球施加力,直到焊球脱落或损坏,通过测量这一过程中所需的最大力值来评估焊球的粘结强度。
二、测试标准与规范
金球推力测试遵循严格的标准规范,以确保测试结果的准确性和可比性。
1、测试参数规范
根据行业标准,金球推力测试的主要参数包括:
推刀高度:焊球高度的1/3-1/2处
接触角度:90±5°
测试速度:50-200μm/s
环境条件:温度23±5℃,相对湿度RH 45±15%
2、失效模式判定
金球推力测试的失效模式主要分为以下几种类型:
TYPE 1:金球完整剥离(PASS)
TYPE 2:金球剥离带少量金属残留(PASS)
TYPE 3:基板弹坑(FAIL)
TYPE 4:推刀接触芯片表面(FAIL)
TYPE 5:部分金球剥离(FAIL)
TYPE 6:金属层脱落(FAIL)
三、测试仪器
1、Alpha W260推拉力测试机

Alpha W260推拉力测试机是专为微电子封装可靠性测试设计的高精度设备,特别适合半导体芯片键合强度的测试需求。
设备特点:
Alpha W260推拉力测试机具有以下突出特点:
高精度:全量程采用高精度数据采集系统,确保测试数据的准确性
多功能性:支持金线拉力、金球推力、锡球推力和晶片推力等多种测试模式
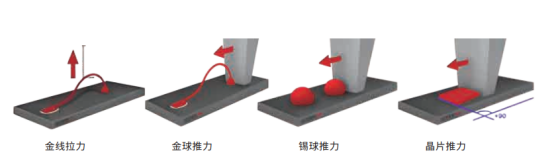
操作便捷:配备专用软件,操作简单,支持多种数据输出格式
智能化:自动数据采集、SPC统计分析、一键报告生成
夹具系统:种规格的剪切工具(适用于不同尺寸焊球)

定制化夹具解决方案

四、测试流程详解
1、试样准备
将储存芯片样品水平固定在测试平台上,确保测试过程中不会移动。
2、设置参数
确定焊球高度并设置推刀位置,推刀高度应为焊球高度的1/3-1/2处。
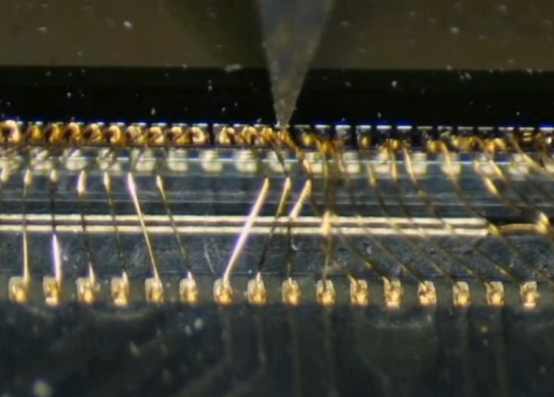
3、推刀水平接近焊球,以100μm/s速度施加推力,直到焊球脱落或损坏。
4、数据记录
系统自动记录峰值推力,这是评估焊球粘结强度的关键数据。
5、结果分析
在显微镜下检查失效形貌,根据失效模式判定标准判断测试结果是否合格。
五、应用领域
金球推力测试广泛应用于多个领域的封装可靠性评估:
LED封装测试

IC半导体封装测试
TO封装测试
IGBT功率模块封装测试
光电子元器件封装测试
汽车电子领域
航天航空领域
军工产品测试
以上就是小编介绍的有关于储存芯片金球推力测试的相关内容了,希望可以给大家带来帮助。如果您还对推拉力测试机怎么使用视频和图解,使用步骤及注意事项、作业指导书,原理、怎么校准和使用方法视频,推拉力测试仪操作规范、使用方法和测试视频,焊接强度测试仪使用方法和键合拉力测试仪等问题感兴趣,欢迎关注我们,也可以给我们私信和留言。【科准测控】小编将持续为大家分享推拉力测试机在锂电池电阻、晶圆、硅晶片、IC半导体、BGA元件焊点、ALMP封装、微电子封装、LED封装、TO封装等领域应用中可能遇到的问题及解决方案。