在电子封装领域,焊点的可靠性直接决定了电子产品的性能和寿命。随着BGA(球栅阵列封装)、CSP(芯片级封装)和WLCSP(晶圆级芯片尺寸封装)等技术的广泛应用,焊点的机械强度和界面结合质量成为关键评估指标。锡球推力测试(Solder Ball Shear Test)作为一种高效的焊点可靠性检测方法,能够精确测量焊球与焊盘之间的抗剪切强度,为焊接工艺优化和产品可靠性验证提供重要依据。

科准测控小编将为您详细介绍锡球推力测试的原理、行业标准、测试设备及操作流程,帮助您全面掌握这一关键测试技术。
一、测试原理
锡球推力测试通过施加水平剪切力于焊球根部,测量其与焊盘分离时的最大剪切力,从而评估焊点的机械强度和界面结合质量。测试过程中,剪切工具以恒定速度推动焊球,记录力-位移曲线,并通过峰值力值判断焊点的可靠性。
关键参数:
剪切高度:通常设置为焊球高度的15%-25%(如15 μm),以确保剪切力作用于焊球与焊盘的界面。
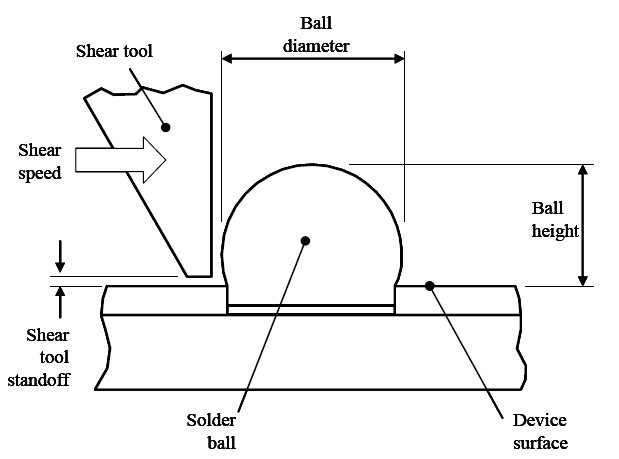
剪切速度:根据标准(如JESD22-B117)推荐,一般为100-500 μm/s(常用200 μm/s)。
失效模式:包括焊球断裂、界面剥离或混合失效,需通过显微镜或SEM进一步分析。
二、行业标准
锡球推力测试需遵循以下国际标准,确保数据可比性和可靠性:
1、JESD22-B117(由JEDEC制定)
规定剪切工具尺寸、剪切高度、测试速度等核心参数。
明确数据统计要求(如样本量≥20个焊球)。
2、IPC-7095(BGA设计与组装指南)
补充焊接工艺对推力测试的影响,如回流焊曲线、焊膏选择等。
3、企业内控标准
部分企业根据产品需求制定更严格的剪切力阈值(如工业级BGA要求单球剪切力≥5N)。
三、测试设备
1、Beta S100推拉力测试机
Beta S100推拉力测试机是专为微电子封装可靠性测试设计的高精度设备,特别适合锡球推力测试需求。

1. 设备特点
高精度:全量程采用24Bit超高分辨率数据采集系统,确保测试数据的准确性。
多功能:支持拉力、推力、剪切力等多种测试模式,适用于不同封装形式。
智能化操作:配备自动数据采集、SPC统计分析及一键报告生成功能。
安全设计:独立安全限位、自动模组识别和防误撞保护,避免样品损坏。
2. 夹具系统
多种规格的剪切工具(适用于不同尺寸焊球)。

钩型拉力夹具,适用于焊球垂直拉拔测试。
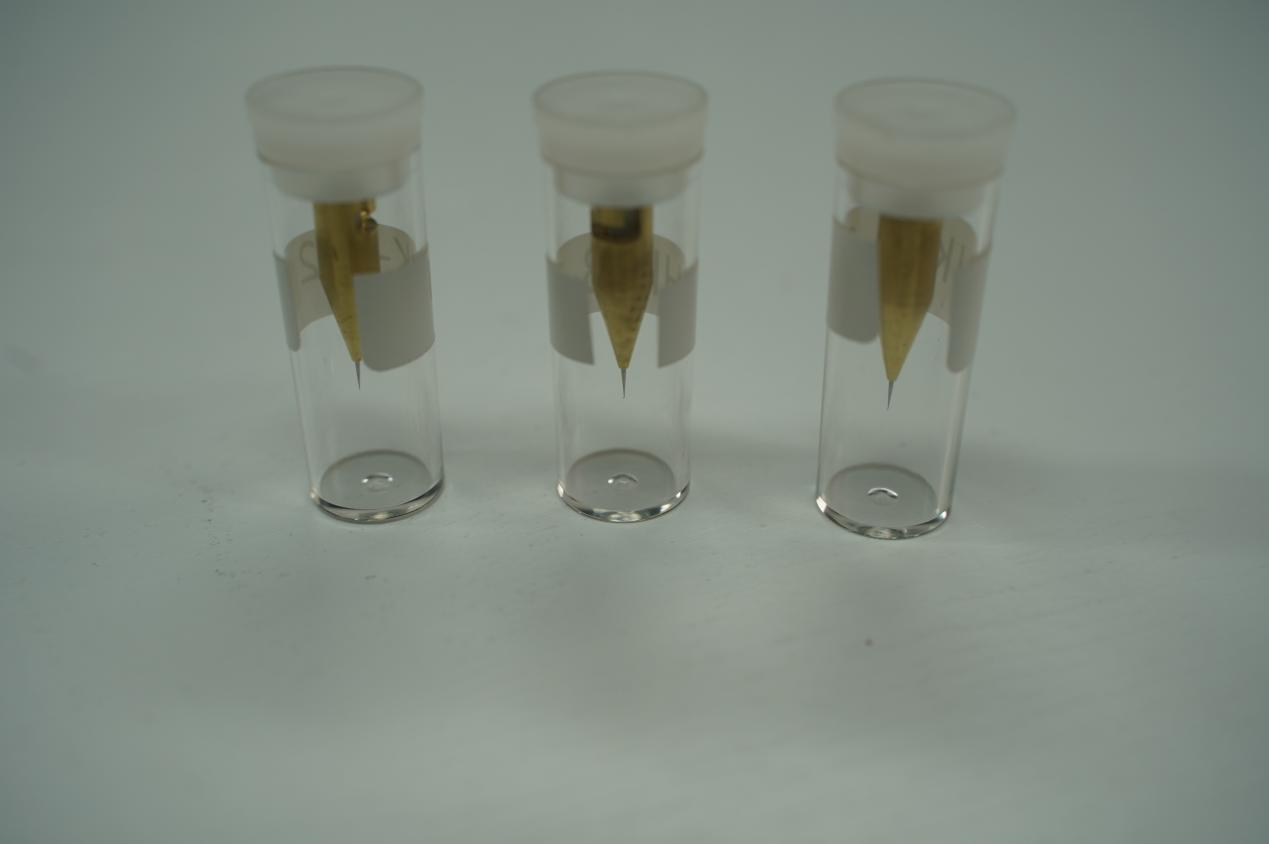
定制化夹具解决方案,满足特殊测试需求。

四、测试流程
1. 样本制备
切割BGA样品至单个焊点单元,或使用未组装的空白基板。
清洁表面,避免污染物影响测试结果。
2. 设备校准
在显微镜下调整剪切工具位置,确保对准焊球根部。
设置剪切高度(如15 μm)和速度(200 μm/s)。
3. 执行测试
启动设备,工具水平推动焊球至脱落,记录力-位移曲线。
保存峰值力值(N)及失效位置图像。
4. 数据分析
统计20个以上焊球的剪切力,计算均值、标准差及CpK。
结合失效模式(如界面断裂或焊球内聚失效)评估工艺缺陷。
以上就是小编介绍的有关于锡球推力测试相关内容了,希望可以给大家带来帮助。如果您还对推拉力测试机怎么使用视频和图解,使用步骤及注意事项、作业指导书,原理、怎么校准和使用方法视频,推拉力测试仪操作规范、使用方法和测试视频,焊接强度测试仪使用方法和键合拉力测试仪等问题感兴趣,欢迎关注我们,也可以给我们私信和留言。【科准测控】小编将持续为大家分享推拉力测试机在锂电池电阻、晶圆、硅晶片、IC半导体、BGA元件焊点、ALMP封装、微电子封装、LED封装、TO封装等领域应用中可能遇到的问题及解决方案。