随着半导体封装技术向微型化、高密度方向发展,晶圆级封装(Wafer Level Packaging, WLP)已成为先进封装技术的重要代表。硅基WLP封装因其优异的电气性能、小型化优势和高可靠性,在移动设备、物联网和人工智能等领域得到广泛应用。然而,在复杂的使用环境和严苛的可靠性要求下,WLP封装界面容易出现开裂、分层等失效问题,严重影响产品可靠性。
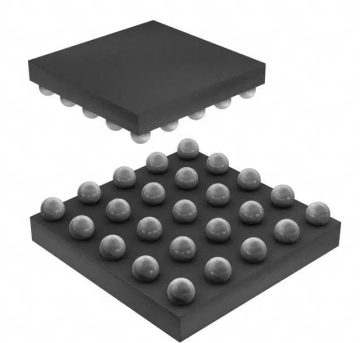
科准测控团队针对这一技术挑战,采用Alpha W260推拉力测试机开展系统性失效分析研究。本文将从测试原理、行业标准、仪器特点和操作流程等方面,全面介绍硅基WLP封装的机械可靠性评估方法,为封装工艺优化和质量控制提供科学依据,助力半导体封装行业提升产品良率和可靠性水平。
一、测试原理
硅基WLP封装失效分析的核心在于评估其内部互连结构的机械强度,主要包括焊球剪切力和焊点拉脱力两个关键指标:
1、剪切测试原理
通过精密控制的剪切工具对焊球施加平行于基板方向的力
测量焊球与基板或芯片间界面剥离所需的峰值力
记录力-位移曲线,分析失效模式和强度特征
2、拉脱测试原理
使用专用夹具垂直拉伸焊球或凸块
测量界面分离时的最大拉力
分析断裂面位置判断失效机理(界面断裂或内聚断裂)
3、失效模式判别:
界面失效:发生在金属与钝化层或UBM层界面
内聚失效:发生在焊料内部或IMC层内部
混合失效:多种失效模式同时存在
二、测试标准
硅基WLP封装推拉力测试遵循以下主要国际标准:
1、JESD22-B117A
焊球剪切测试标准方法
规定测试速度、工具几何尺寸等关键参数
定义剪切高度一般为焊球高度的25%
2、JESD22-B109
焊球拉脱测试标准
规范夹具设计、粘接方法和测试条件
3、MIL-STD-883 Method 2019.7
微电子器件键合强度测试方法
包含剪切和拉脱两种测试程序
4、IPC/JEDEC-9704
晶圆级封装可靠性表征标准
特别针对WLP封装的机械可靠性评估
三、测试仪器
1、Alpha W260推拉力测试机

Alpha W260推拉力测试机是专为微电子封装可靠性测试设计的高精度设备,特别适合红外探测器芯片的测试需求:
1、设备特点
高精度:全量程采用自主研发的高精度数据采集系统,确保测试数据的准确性。
功能性:支持多种测试模式,如晶片推力测试、金球推力测试、金线拉力测试以及剪切力测试等。
操作便捷:配备专用软件,操作简单,支持多种数据输出格式,能够wan美匹配工厂的SPC网络系统。
2、多功能测试能力
支持拉力/剪切/推力测试
模块化设计灵活配置
3、智能化操作
自动数据采集
SPC统计分析
一键报告生成
4、安全可靠设计
独立安全限位
自动模组识别
防误撞保护
5、夹具系统
多种规格的剪切工具(适用于不同尺寸焊球)

钩型拉力夹具
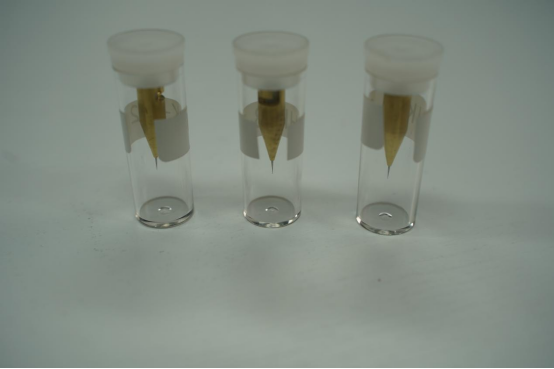
定制化夹具解决方案

2、KZ-68SC-05XY万能材料试验机
搭配定制夹具,进行焊球垂直拉拔测试

四、测试流程
1. 样品准备阶段
样品固定:使用真空吸附或专用夹具将样品固定在测试平台
光学对位:通过显微镜观察系统定位待测焊球
高度测量:采用激光或光学方式测量焊球高度
2. 剪切测试流程
设置剪切工具与基板间距(通常为焊球高度的25%)
设定测试速度(通常为100-500μm/s)
选择剪切方向(通常平行于芯片边缘)
执行剪切测试,记录峰值力和位移曲线
采集失效后图像,分析断裂面特征
3. 拉脱测试流程

(示意图)
选择合适的上拉夹具(钩状或粘接型)
定位夹具与焊球中心对准
设定拉伸速度和最大行程
执行拉脱测试,记录最大拉力
检查断裂面,判断失效位置
4. 数据分析阶段
统计处理测试数据,计算平均值和标准差
分析力-位移曲线特征
分类统计失效模式比例
生成测试报告,包括:
原始测试数据
统计结果
典型失效图片
工艺改进建议
五、应用案例
某300mm硅基WLP产品在可靠性测试中出现早期失效,采用Alpha W260进行系统分析:
1、问题现象
温度循环测试后部分器件功能失效
初步怀疑焊球界面可靠性问题
2、分析过程
选取正常和失效区域样品各20个
进行剪切力测试(参数:剪切高度30μm,速度200μm/s)
结果显示失效区域平均剪切力下降约35%
断裂面分析显示界面失效比例从15%增至65%
3、根本原因
UBM(Under Bump Metallization)层厚度不均
电镀工艺波动导致局部结合力不足
4、改进措施
优化UBM电镀工艺参数
增加过程监控点
改进后测试显示剪切力一致性提高40%
以上就是小编介绍的有关于硅基WLP封装失效分析的相关内容了,希望可以给大家带来帮助。如果您还对硅基WLP封装失效分析方法、测试报告和测试项目,推拉力测试机怎么使用视频和图解,使用步骤及注意事项、作业指导书,原理、怎么校准和使用方法视频,推拉力测试仪操作规范、使用方法和测试视频,焊接强度测试仪使用方法和键合拉力测试仪等问题感兴趣,欢迎关注我们,也可以给我们私信和留言。【科准测控】小编将持续为大家分享推拉力测试机在锂电池电阻、晶圆、硅晶片、IC半导体、BGA元件焊点、ALMP封装、微电子封装、LED封装、TO封装等领域应用中可能遇到的问题及解决方案。